SMT menggunakan analisis dan solusi rongga pengelasan reflow udara pasta solder konvensional (Edisi Essence 2023), Anda pantas mendapatkannya!
1 Pendahuluan

Dalam perakitan papan sirkuit, pasta solder dicetak terlebih dahulu pada bantalan solder papan sirkuit, kemudian berbagai komponen elektronik ditempelkan. Terakhir, setelah tungku reflow, butiran timah dalam pasta solder dilelehkan dan berbagai komponen elektronik serta bantalan solder papan sirkuit dilas bersama untuk mewujudkan perakitan submodul listrik. Teknologi pemasangan permukaan (SMT) semakin banyak digunakan dalam produk kemasan berdensitas tinggi, seperti paket tingkat sistem (SIP), perangkat BallGridArray (BGA), dan perangkat chip tanpa timbal (QFN) tanpa daya, paket datar persegi tanpa pin (quadAATNo-lead).
Karena karakteristik proses pengelasan pasta solder dan bahannya, setelah pengelasan reflow pada perangkat permukaan solder yang besar ini, akan muncul lubang pada area pengelasan solder, yang akan memengaruhi sifat kelistrikan, sifat termal, dan sifat mekanis kinerja produk, dan bahkan menyebabkan kegagalan produk. Oleh karena itu, untuk memperbaiki rongga pengelasan reflow pasta solder telah menjadi proses dan masalah teknis yang harus dipecahkan. Beberapa peneliti telah menganalisis dan mempelajari penyebab rongga pengelasan bola solder BGA, dan memberikan solusi perbaikan. Proses pengelasan reflow pasta solder konvensional pada area pengelasan QFN yang lebih besar dari 10 mm2 atau area pengelasan yang lebih besar dari 6 mm2, solusi chip kosong masih kurang.
Gunakan pengelasan solder preform dan pengelasan tungku refluks vakum untuk memperbaiki lubang las. Solder prefabrikasi membutuhkan peralatan khusus untuk mengarahkan fluks. Misalnya, chip akan diimbangi dan dimiringkan secara signifikan setelah chip ditempatkan langsung di atas solder prefabrikasi. Jika chip dudukan fluks di-reflow lalu diarahkan, prosesnya akan meningkat dua kali reflow, dan biaya solder prefabrikasi serta material fluks jauh lebih tinggi daripada pasta solder.
Peralatan refluks vakum lebih mahal, kapasitas vakum ruang vakum independen sangat rendah, kinerja biaya rendah, dan masalah cipratan timah serius, yang merupakan faktor penting dalam penerapan produk berdensitas tinggi dan berpitch kecil. Dalam makalah ini, berdasarkan proses pengelasan reflow pasta solder konvensional, proses pengelasan reflow sekunder baru dikembangkan dan diperkenalkan untuk memperbaiki rongga pengelasan dan mengatasi masalah ikatan dan retak segel plastik yang disebabkan oleh rongga pengelasan.
2 Pasta solder pencetakan reflow pengelasan rongga dan mekanisme produksi
2.1 Rongga pengelasan
Setelah pengelasan reflow, produk diuji di bawah sinar-X. Lubang-lubang di zona pengelasan dengan warna yang lebih terang ditemukan disebabkan oleh kurangnya solder pada lapisan las, seperti yang ditunjukkan pada Gambar 1.
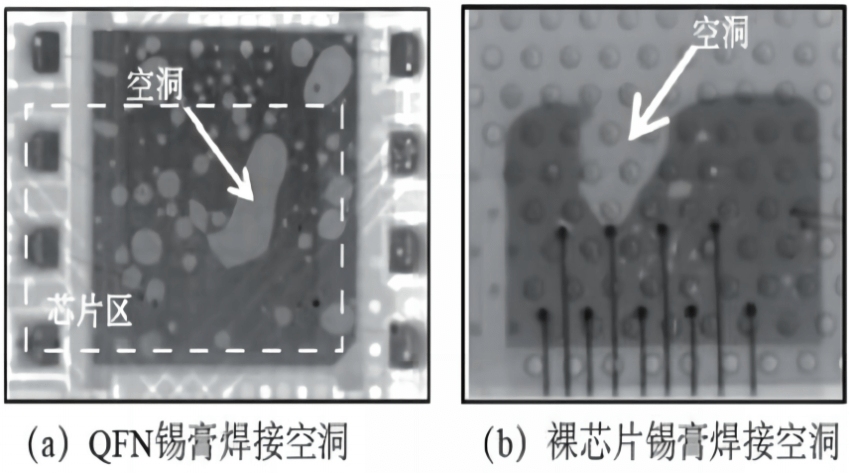
Deteksi sinar-X pada lubang gelembung
2.2 Mekanisme pembentukan rongga pengelasan
Mengambil pasta solder sAC305 sebagai contoh, komposisi dan fungsi utamanya ditunjukkan pada Tabel 1. Fluks dan manik-manik timah direkatkan menjadi pasta. Rasio berat solder timah terhadap fluks sekitar 9:1, dan rasio volume sekitar 1:1.

Setelah pasta solder dicetak dan dipasang pada berbagai komponen elektronik, pasta solder akan menjalani empat tahap: pemanasan awal, aktivasi, refluks, dan pendinginan saat melewati tungku refluks. Kondisi pasta solder juga berbeda-beda pada suhu yang berbeda di setiap tahapnya, seperti yang ditunjukkan pada Gambar 2.
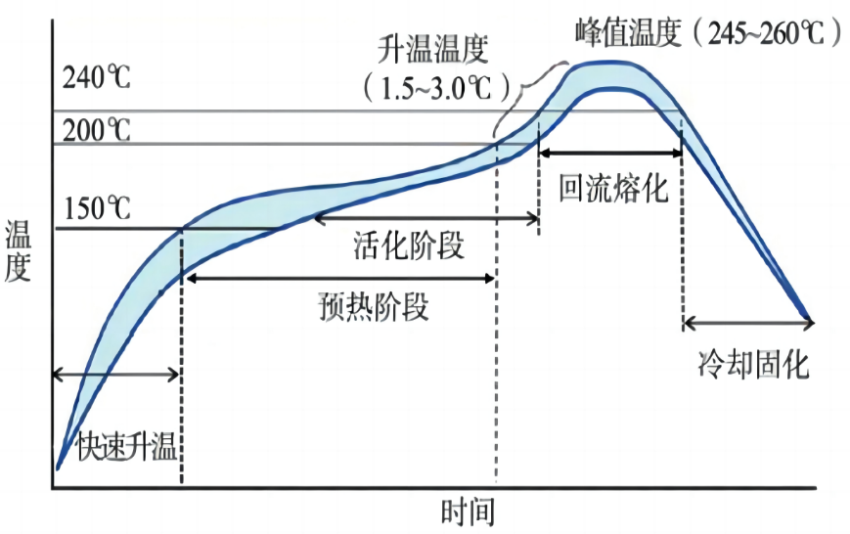
Referensi profil untuk setiap area penyolderan reflow
Pada tahap pemanasan awal dan aktivasi, komponen volatil dalam fluks pasta solder akan menguap menjadi gas saat dipanaskan. Pada saat yang sama, gas akan dihasilkan ketika oksida pada permukaan lapisan las dihilangkan. Sebagian gas ini akan menguap dan meninggalkan pasta solder, sementara manik-manik solder akan terkondensasi rapat akibat penguapan fluks. Pada tahap refluks, sisa fluks dalam pasta solder akan menguap dengan cepat, manik-manik timah akan meleleh, sejumlah kecil gas volatil fluks dan sebagian besar udara di antara manik-manik timah tidak akan terdispersi tepat waktu, dan residu dalam timah cair dan di bawah tekanan timah cair membentuk struktur sandwich hamburger dan terperangkap oleh bantalan solder papan sirkuit dan komponen elektronik. Gas yang terbungkus dalam timah cair sulit dilepaskan hanya karena daya apung ke atas. Waktu peleburan bagian atas sangat singkat. Ketika timah cair mendingin dan menjadi timah padat, pori-pori muncul di lapisan las dan lubang solder terbentuk, seperti yang ditunjukkan pada Gambar 3.
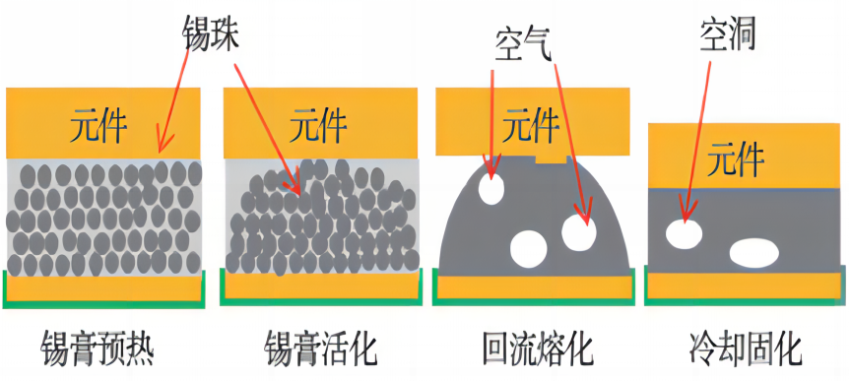
Diagram skematis rongga yang dihasilkan oleh pengelasan reflow pasta solder
Akar penyebab rongga las adalah udara atau gas volatil yang terbungkus dalam pasta solder setelah peleburan tidak sepenuhnya terbuang. Faktor-faktor yang memengaruhinya meliputi bahan pasta solder, bentuk cetakan pasta solder, jumlah cetakan pasta solder, suhu refluks, waktu refluks, ukuran pengelasan, struktur, dan sebagainya.
3. Verifikasi faktor-faktor yang mempengaruhi lubang las reflow pencetakan pasta solder
Uji QFN dan bare chip digunakan untuk mengonfirmasi penyebab utama rongga pengelasan reflow, dan untuk menemukan cara memperbaiki rongga pengelasan reflow yang dicetak oleh pasta solder. Profil produk pengelasan reflow pasta solder QFN dan bare chip ditunjukkan pada Gambar 4, ukuran permukaan pengelasan QFN adalah 4,4mm x 4,1mm, permukaan pengelasan adalah lapisan timah (100% timah murni); Ukuran pengelasan bare chip adalah 3,0mm x 2,3mm, lapisan pengelasan adalah lapisan bimetalik nikel-vanadium yang disputter, dan lapisan permukaannya adalah vanadium. Bantalan las substrat adalah nikel-paladium celup emas tanpa listrik, dan ketebalannya adalah 0,4μm/0,06μm/0,04μm. Pasta solder SAC305 digunakan, peralatan pencetakan pasta solder adalah DEK Horizon APix, peralatan tungku refluks adalah BTUPyramax150N, dan peralatan sinar-X adalah DAGExD7500VR.
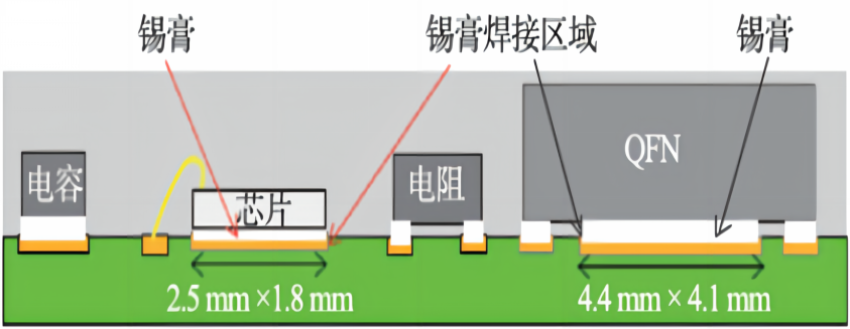
Gambar pengelasan QFN dan chip kosong
Untuk memudahkan perbandingan hasil pengujian, pengelasan reflow dilakukan pada kondisi di Tabel 2.

Tabel kondisi pengelasan reflow
Setelah pemasangan permukaan dan pengelasan reflow selesai, lapisan pengelasan dideteksi dengan sinar-X, dan ditemukan bahwa ada lubang besar di lapisan pengelasan di bagian bawah QFN dan chip kosong, seperti yang ditunjukkan pada Gambar 5.
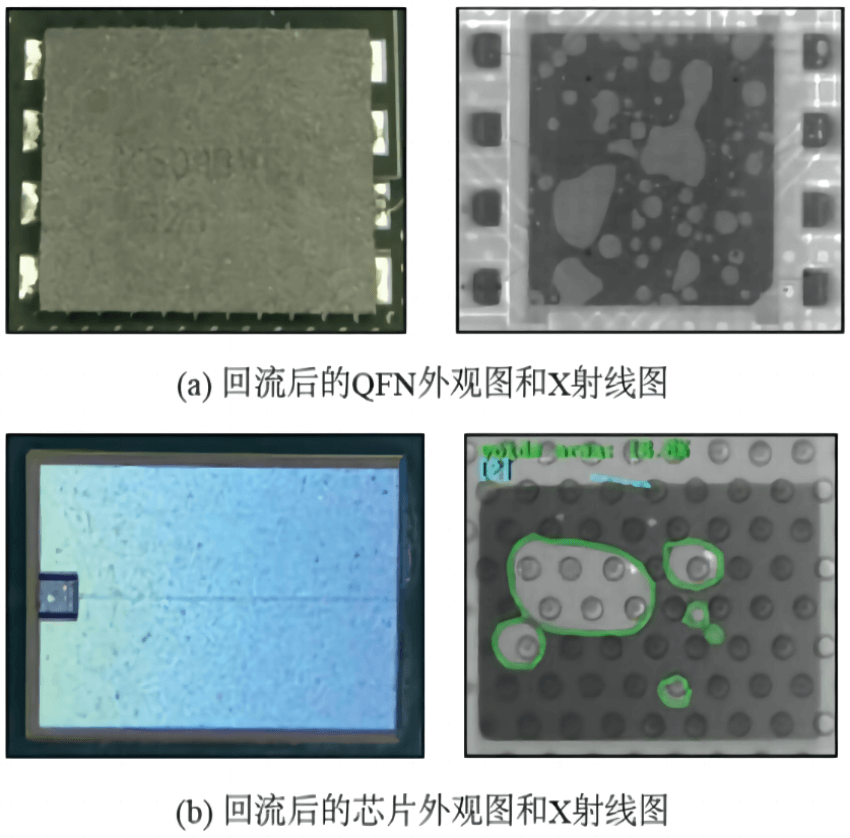
QFN dan Hologram Chip (Sinar-X)
Karena ukuran manik timah, ketebalan kasa baja, laju area bukaan, bentuk kasa baja, waktu refluks, dan suhu puncak tungku akan memengaruhi rongga pengelasan reflow, terdapat banyak faktor yang memengaruhi, yang akan diverifikasi langsung melalui uji DOE, dan jumlah kelompok eksperimen akan terlalu besar. Oleh karena itu, perlu segera menyaring dan menentukan faktor-faktor utama yang memengaruhi melalui uji perbandingan korelasi, dan kemudian mengoptimalkan faktor-faktor utama yang memengaruhi melalui DOE.
3.1 Dimensi lubang solder dan manik timah pasta solder
Dengan uji pasta solder SAC305 tipe 3 (ukuran manik 25-45 μm), kondisi lainnya tetap sama. Setelah reflow, lubang pada lapisan solder diukur dan dibandingkan dengan pasta solder tipe 4. Ditemukan bahwa lubang pada lapisan solder tidak berbeda secara signifikan antara kedua jenis pasta solder, yang menunjukkan bahwa pasta solder dengan ukuran manik yang berbeda tidak berpengaruh nyata terhadap lubang pada lapisan solder, yang bukan merupakan faktor yang berpengaruh, seperti yang ditunjukkan pada Gambar 6.

Perbandingan lubang bubuk timah metalik dengan ukuran partikel yang berbeda
3.2 Ketebalan rongga las dan jaring baja cetak
Setelah reflow, luas rongga lapisan las diukur dengan kasa baja cetak setebal 50 μm, 100 μm, dan 125 μm, sementara kondisi lainnya tetap sama. Ditemukan bahwa pengaruh perbedaan ketebalan kasa baja (pasta solder) terhadap QFN dibandingkan dengan kasa baja cetak setebal 75 μm. Seiring bertambahnya ketebalan kasa baja, luas rongga akan berkurang secara perlahan. Setelah mencapai ketebalan tertentu (100 μm), luas rongga akan berbalik arah dan mulai bertambah seiring bertambahnya ketebalan kasa baja, seperti ditunjukkan pada Gambar 7.
Hal ini menunjukkan bahwa ketika jumlah pasta solder ditingkatkan, timah cair dengan refluks tertutup oleh chip, dan saluran keluar udara sisa hanya menyempit di keempat sisinya. Ketika jumlah pasta solder diubah, saluran keluar udara sisa juga meningkat, dan semburan udara seketika yang terbungkus timah cair atau gas volatil yang keluar dari timah cair akan menyebabkan timah cair memercik di sekitar QFN dan chip.
Pengujian menemukan bahwa dengan bertambahnya ketebalan jaring baja, pecahnya gelembung akibat keluarnya udara atau gas yang mudah menguap juga akan meningkat, dan kemungkinan tercipratnya timah ke sekitar QFN dan chip juga akan meningkat.

Perbandingan lubang pada jaring baja dengan ketebalan berbeda
3.3 Rasio luas rongga las dan bukaan kasa baja
Jaring baja cetak dengan tingkat bukaan 100%, 90%, dan 80% diuji, dan kondisi lainnya tetap sama. Setelah reflow, luas rongga lapisan las diukur dan dibandingkan dengan jaring baja cetak dengan tingkat bukaan 100%. Ditemukan bahwa tidak terdapat perbedaan yang signifikan pada rongga lapisan las pada kondisi tingkat bukaan 100%, 90%, dan 80%, seperti yang ditunjukkan pada Gambar 8.

Perbandingan rongga pada area bukaan yang berbeda pada jaring baja yang berbeda
3.4 Rongga las dan bentuk jaring baja cetak
Dengan uji bentuk cetak pasta solder strip b dan kisi miring c, kondisi lainnya tetap sama. Setelah reflow, luas rongga lapisan las diukur dan dibandingkan dengan bentuk cetak kisi a. Ditemukan bahwa tidak ada perbedaan yang signifikan pada rongga lapisan las pada kondisi kisi, strip, dan kisi miring, seperti yang ditunjukkan pada Gambar 9.
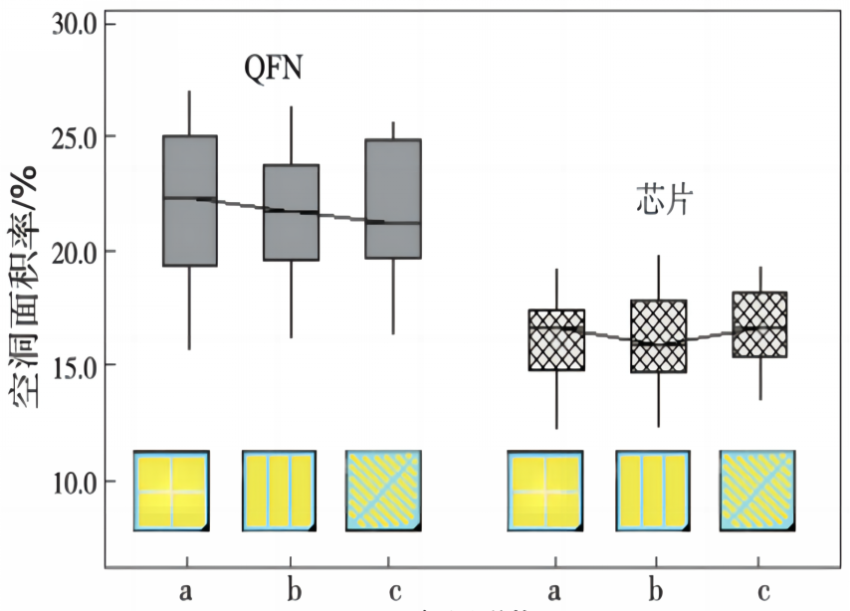
Perbandingan lubang pada berbagai mode pembukaan jaring baja
3.5 Rongga pengelasan dan waktu refluks
Setelah pengujian waktu refluks yang lama (70 detik, 80 detik, 90 detik), kondisi lainnya tetap tidak berubah. Lubang pada lapisan las diukur setelah refluks, dan dibandingkan dengan waktu refluks 60 detik. Ditemukan bahwa seiring bertambahnya waktu refluks, luas lubang las berkurang, tetapi amplitudo reduksi menurun secara bertahap seiring bertambahnya waktu, seperti yang ditunjukkan pada Gambar 10. Hal ini menunjukkan bahwa jika waktu refluks tidak mencukupi, peningkatan waktu refluks akan menyebabkan luapan penuh udara yang terbungkus timah cair cair. Namun, setelah waktu refluks meningkat hingga waktu tertentu, udara yang terbungkus timah cair sulit untuk meluap lagi. Waktu refluks merupakan salah satu faktor yang memengaruhi rongga las.

Perbandingan rongga dengan panjang waktu refluks yang berbeda
3.6 Rongga pengelasan dan suhu puncak tungku
Dengan uji suhu tungku puncak 240 ℃ dan 250 ℃ dan kondisi lain tidak berubah, luas rongga lapisan las diukur setelah reflow, dan dibandingkan dengan suhu tungku puncak 260 ℃, ditemukan bahwa di bawah kondisi suhu tungku puncak yang berbeda, rongga lapisan las QFN dan chip tidak berubah secara signifikan, seperti yang ditunjukkan pada Gambar 11. Ini menunjukkan bahwa suhu tungku puncak yang berbeda tidak memiliki efek yang jelas pada QFN dan lubang di lapisan las chip, yang bukan merupakan faktor yang mempengaruhi.

Perbandingan kekosongan suhu puncak yang berbeda
Pengujian di atas menunjukkan bahwa faktor signifikan yang mempengaruhi rongga lapisan las QFN dan chip adalah waktu refluks dan ketebalan kasa baja.
4 Perbaikan rongga pengelasan reflow pencetakan pasta solder
4.1 Uji DOE untuk meningkatkan rongga pengelasan
Lubang pada lapisan las QFN dan chip ditingkatkan dengan menemukan nilai optimal dari faktor-faktor yang mempengaruhi utama (waktu refluks dan ketebalan jaring baja). Pasta solder adalah SAC305 tipe4, bentuk jaring baja adalah tipe kisi (derajat pembukaan 100%), suhu tungku puncak adalah 260 ℃, dan kondisi uji lainnya sama dengan peralatan uji. Uji DOE dan hasilnya ditunjukkan pada Tabel 3. Pengaruh ketebalan jaring baja dan waktu refluks pada lubang las QFN dan chip ditunjukkan pada Gambar 12. Melalui analisis interaksi faktor-faktor yang mempengaruhi utama, ditemukan bahwa menggunakan ketebalan jaring baja 100 μm dan waktu refluks 80 detik dapat secara signifikan mengurangi rongga las QFN dan chip. Laju rongga las QFN berkurang dari maksimum 27,8% menjadi 16,1%, dan laju rongga las chip berkurang dari maksimum 20,5% menjadi 14,5%.
Dalam pengujian ini, 1000 produk diproduksi dalam kondisi optimal (ketebalan kasa baja 100 μm, waktu refluks 80 detik), dan laju rongga pengelasan 100 QFN dan keping diukur secara acak. Rata-rata laju rongga pengelasan QFN adalah 16,4%, dan rata-rata laju rongga pengelasan keping adalah 14,7%. Laju rongga pengelasan keping dan keping secara signifikan berkurang.

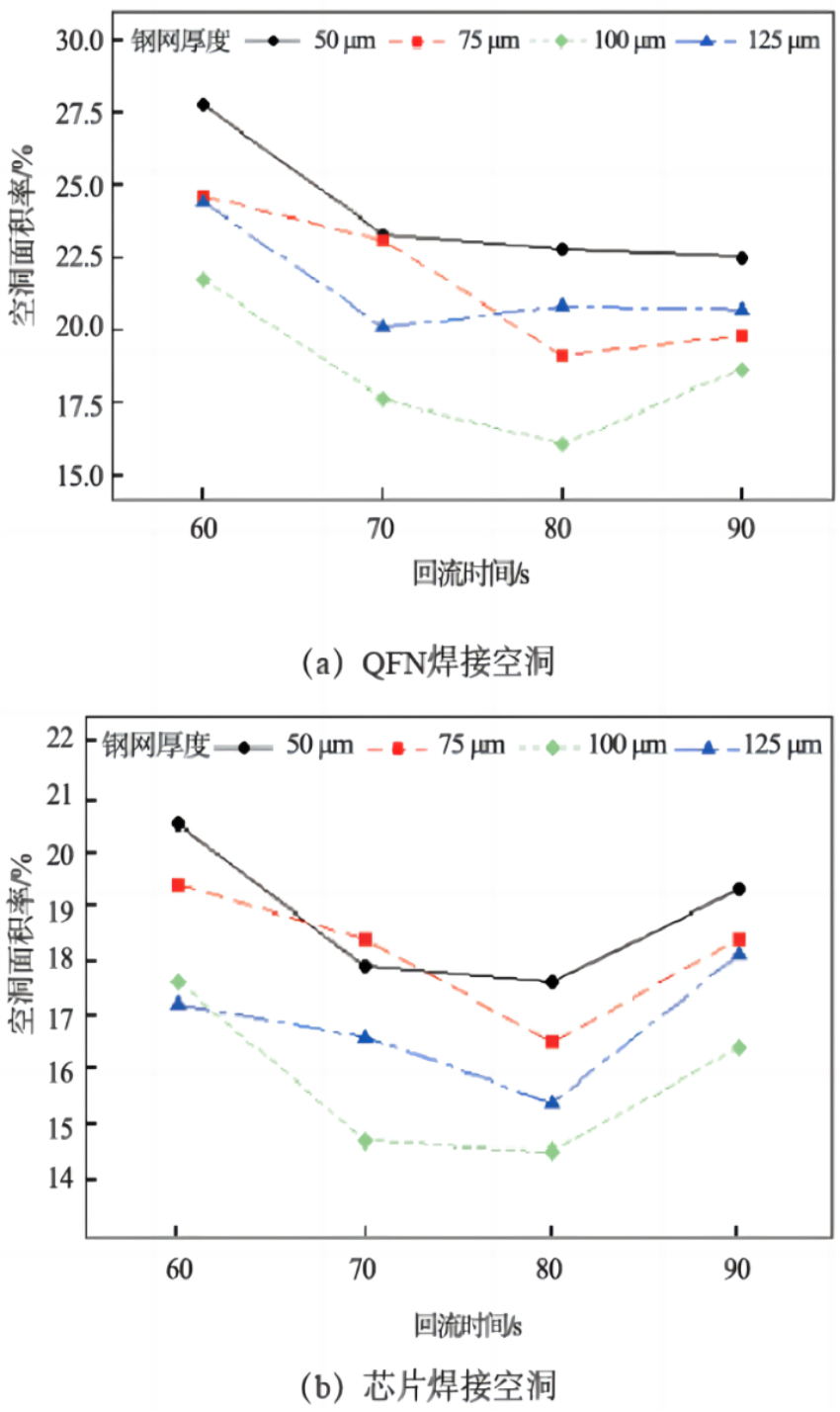
4.2 Proses baru meningkatkan rongga pengelasan
Kondisi produksi aktual dan pengujian menunjukkan bahwa ketika luas rongga las di bagian bawah chip kurang dari 10%, masalah retak posisi rongga chip tidak akan terjadi selama proses pengikatan dan pencetakan timbal. Parameter proses yang dioptimalkan oleh DOE tidak dapat memenuhi persyaratan analisis dan penyelesaian lubang pada pengelasan reflow pasta solder konvensional, sehingga laju luas rongga las chip perlu dikurangi lebih lanjut.
Karena chip yang dilapisi solder mencegah gas dalam solder keluar, laju lubang di bagian bawah chip semakin berkurang dengan menghilangkan atau mengurangi gas yang terlapisi solder. Proses pengelasan reflow baru dengan dua pencetakan pasta solder diadopsi: satu pencetakan pasta solder, satu reflow yang tidak menutupi QFN dan chip kosong yang mengeluarkan gas dalam solder; Proses spesifik pencetakan pasta solder sekunder, patch, dan refluks sekunder ditunjukkan pada Gambar 13.
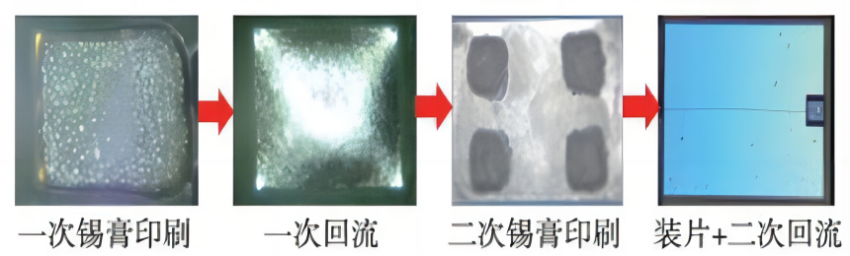
Ketika pasta solder setebal 75μm dicetak untuk pertama kalinya, sebagian besar gas dalam solder tanpa penutup chip keluar dari permukaan, dan ketebalan setelah refluks sekitar 50μm. Setelah refluks primer selesai, kotak-kotak kecil dicetak pada permukaan solder padat yang didinginkan (untuk mengurangi jumlah pasta solder, mengurangi jumlah luapan gas, mengurangi atau menghilangkan percikan solder), dan pasta solder dengan ketebalan 50 μm (hasil pengujian di atas menunjukkan bahwa 100 μm adalah yang terbaik, sehingga ketebalan pencetakan sekunder adalah 100 μm.50 μm=50 μm), kemudian pasang chip, dan kemudian kembali melalui 80 detik. Hampir tidak ada lubang pada solder setelah pencetakan dan reflow pertama, dan pasta solder pada pencetakan kedua kecil, dan lubang pengelasan kecil, seperti yang ditunjukkan pada Gambar 14.
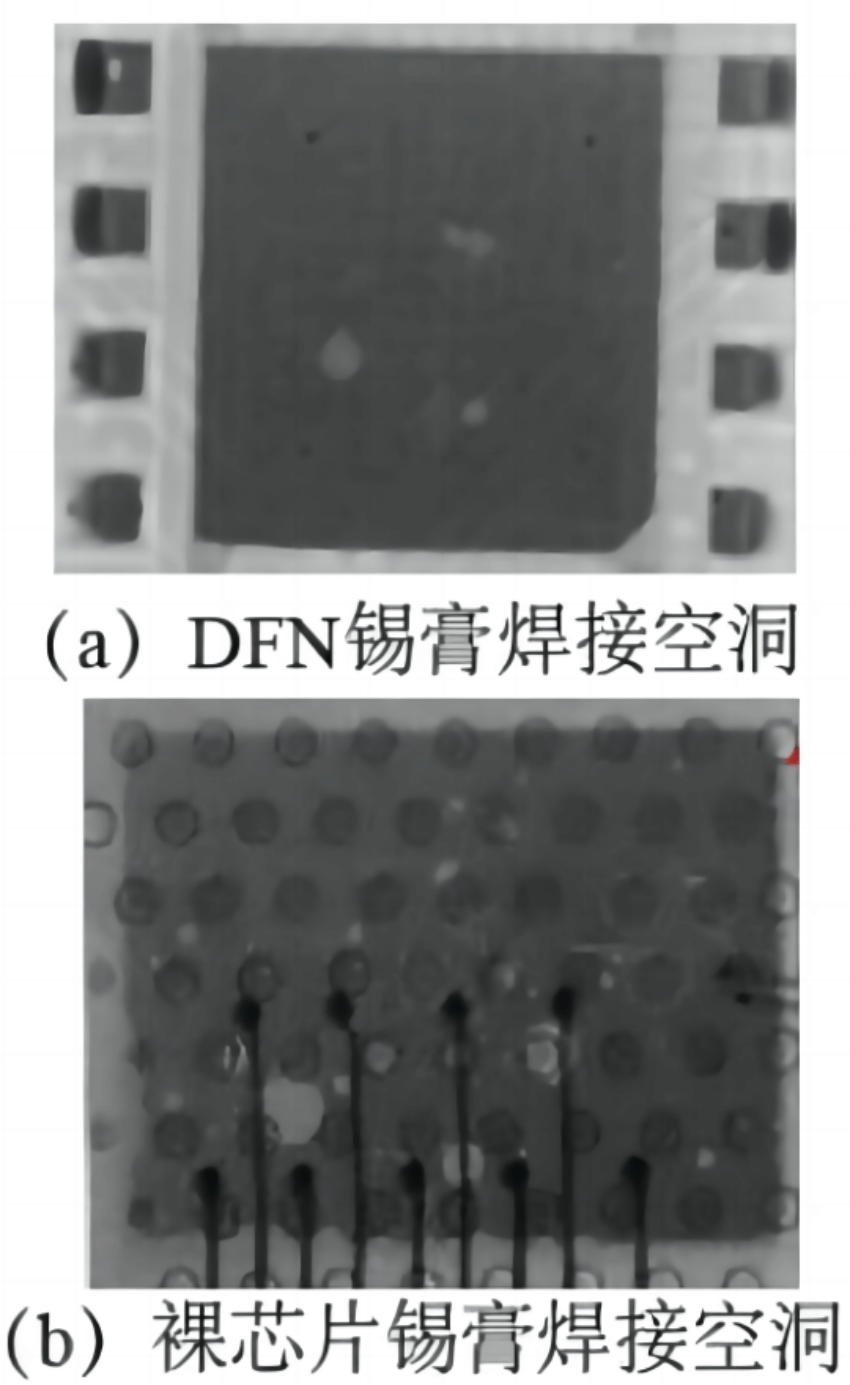
Setelah dua kali pencetakan pasta solder, gambar berongga
4.3 Verifikasi efek rongga pengelasan
Produksi 2000 produk (ketebalan jaring baja cetak pertama adalah 75 μm, ketebalan jaring baja cetak kedua adalah 50 μm), kondisi lain tidak berubah, pengukuran acak 500 QFN dan laju rongga pengelasan chip, menemukan bahwa proses baru setelah refluks pertama tidak ada rongga, setelah refluks kedua QFN Laju rongga pengelasan maksimum adalah 4,8%, dan laju rongga pengelasan maksimum chip adalah 4,1%. Dibandingkan dengan proses pengelasan cetak pasta tunggal asli dan proses yang dioptimalkan DOE, rongga pengelasan berkurang secara signifikan, seperti yang ditunjukkan pada Gambar 15. Tidak ada retakan chip yang ditemukan setelah uji fungsional semua produk.

5 Ringkasan
Optimalisasi jumlah pasta solder yang dicetak dan waktu refluks dapat mengurangi luas rongga pengelasan, tetapi laju rongga pengelasan tetap besar. Penggunaan dua teknik pengelasan reflow dengan pencetakan pasta solder dapat secara efektif memaksimalkan laju rongga pengelasan. Luas pengelasan chip polos sirkuit QFN dapat mencapai 4,4 mm x 4,1 mm dan 3,0 mm x 2,3 mm dalam produksi massal. Laju rongga pengelasan reflow dikontrol di bawah 5%, yang meningkatkan kualitas dan keandalan pengelasan reflow. Penelitian dalam makalah ini memberikan referensi penting untuk memperbaiki permasalahan rongga pengelasan pada permukaan pengelasan area luas.






